ハードウェアの発展を阻害しているのは「マザーボード」だという指摘、マザーボードに代わる次世代技術とは?

By maxxyustas
電気工学などの専門職団体IEEEが運営するハードウェア・エンジニアリングに関するニュースサイトIEEE Spectrumが「さようなら、マザーボード」と題して、「マザーボードのようなプリント基板こそがハードウェアの発展を阻害している」と主張しています。
Goodbye Motherboard Hello Siliconinterconnect Fabric - IEEE Spectrum
https://spectrum.ieee.org/computing/hardware/goodbye-motherboard-hello-siliconinterconnect-fabric
スマートフォンやノートPCなどのデバイスは可能な限りの「小ささ」が求められています。しかし、問題点は「プリント基板」にあるとのこと。スマートフォンなどの中核部品であるSoCを見ると、その機能の本質的な部分であるチップはSoC自体の20分の1の大きさしかありません。チップを20倍の大きさのパッケージにわざわざ収めるのは、プリント基板が原因です。

By NomadSoul1
プリント基板はその構造上、どうしても「反り」が産まれてしまいます。チップをはんだバンプしようとする際、プリント基板の反りが原因で、電力供給や信号の送受信に必要な距離にまでチップとプリント基板を近づけることが困難です。それゆえ、シリコンチップをパッケージ化して集積回路として、プリント基板にはんだバンプする必要があるわけです。
チップとパッケージのサイズ差がもたらす影響は甚大です。当然ながらパッケージが大きくなるということは、省スペース化が困難になるということで、スマートフォンやスマートウォッチなどの「小ささ」が重要になるデバイスの目的に反しています。さらに、ほとんどのプリント基板上で行われているように、チップ間で相互通信が行われている場合、チップ間の距離が広がれば広がるほど処理速度が低下します。

By grafvision
このサイズの問題に加えて、パッケージ化されてしまうと、放熱効率が悪化するという問題も存在します。この放熱問題は何十年にわたって、ハードウェアにおける重大な問題になっています。
これらの問題を解決してくれるのが、シリコン片上の配線にチップをダイレクトに接続するという「シリコン相互接続ファブリック(Silicon-interconnect fabric、Si-IF)」です。プリント基板とICなどのパッケージを撤廃し、500µmから1mmという比較的厚めのシリコンにチップ・プロセッサ・メモリダイ・RFチップレット・VRM・インダクタ・コンデンサーなどを接着した場合、層状に配線をつなぐことによって、プリント基板に比べて各チップ間の距離を500µmから2µmにまで引き下げることが可能です。さらに、チップとI/Oポートの間の距離を500μmから10μmに縮めることができるため、格段に省スペース化が可能。この省スペース化によって、チップ間の距離が近くなるため、プロセッサのパフォーマンスが向上します。加えて、シリコンは熱伝導性に優れた素材であるため、シリコン基板上にヒートシンクを取り付ければ、放熱性を70%も高めることが可能とのこと。
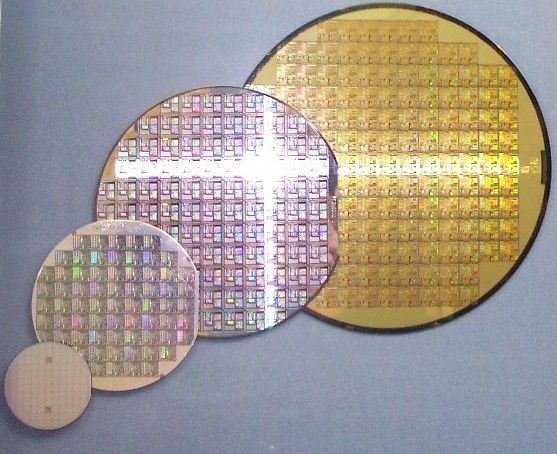
一方で、シリコンの欠点はその価格にあります。プリント基板の材料であるFR-4に比べてシリコンは単位面積当たり10倍も高額だとIEEEは述べています。しかし、省スペース化によって得られる利点によって、この価格の差は十分相殺可能だとのことです。
このSi-IFの設計・試作は現在進行中で、カリフォルニア大学ロサンゼルス校とイリノイ大学アーバナ・シャンペーン校の合同研究グループが、40個のチップを持つSi-IFのGPUを試験的に作成したとのこと。このGPUは従来式のプリント基板上の40個のチップを接続したGPUに比べて、5倍の演算速度を達成しながらも、エネルギー消費量を80%も削減することに成功したそうです。
Si-IFのメリットは製造面にも存在します。SoCは面積が大きくなればなるほど歩留まりが指数関数的に低下するという特徴を持ち、設計が困難であるため、製造コストも高く付きます。一方、Si-IFはシリコン基板にチップをダイレクトに接続するというものなので、設計も安価。さらに、シリコン基板はごく単純な構造なので、歩留まりもほぼ100%とのこと。
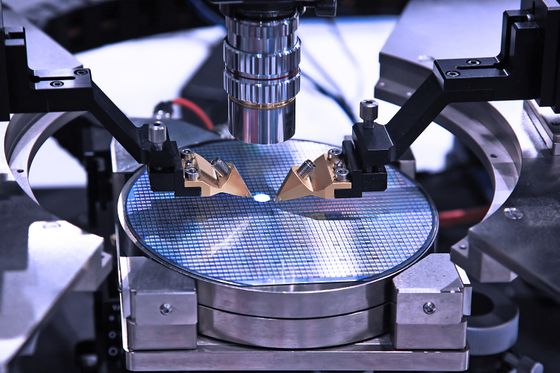
By ssp48
このSi-IFを実用化するためには、まだ何点か問題が残されています。1つ目は商業レベルで使用可能なSi-IF製造プロセスを確立してデモンストレーションすること。2つ目はシリコンの優れた熱伝導率を生かせる新型ヒートシンクを設計すること。3つ目はシリコンに特化したシャーシ・マウント・コネクタ・ケーブルを設計すること。4つ目はSi-IFはシリコンにチップを直接接着するという特性上チップの交換が困難なため、冗長性を確保する必要があるということ。
この他にも問題は存在しますが、アメリカ国防高等研究計画局(DARPA)のCommon Heterogeneous Integration and IP Reuse Strategies(CHIPS)というプロジェクトでは、すでにいくつかの問題の解決に取りかかっているそうです。
・関連記事
CPUよりも最大1万倍の速度で演算可能な機械学習向け処理装置「メモリスタチップ」のプロトタイプが登場 - GIGAZINE
シリコンに代わるカーボンナノチューブを用いたプロセッサの作成に研究者が成功 - GIGAZINE
1兆2000億個ものトランジスタを搭載した史上最大のコンピューターチップが開発される - GIGAZINE
ムーアの法則の限界を突破する「金属-空気トランジスタ」が半導体を置き換える可能性 - GIGAZINE
シリコン半導体技術を活用して量子コンピューターのキュービットを作り出せる新技術「Flip-flop qubit」 - GIGAZINE
・関連コンテンツ
in ハードウェア, Posted by darkhorse_log
You can read the machine translated English article Pointed out that 'motherboard' is hinder….